지난 포스트에서 포토 공정에서 해상도가 좋으면 좋을수록 (= 패턴의 크기가 작으면 작을수록) 웨이퍼 1 매 당 팔 수 있는 CHIP의 개수가 많아진다고 했었다.
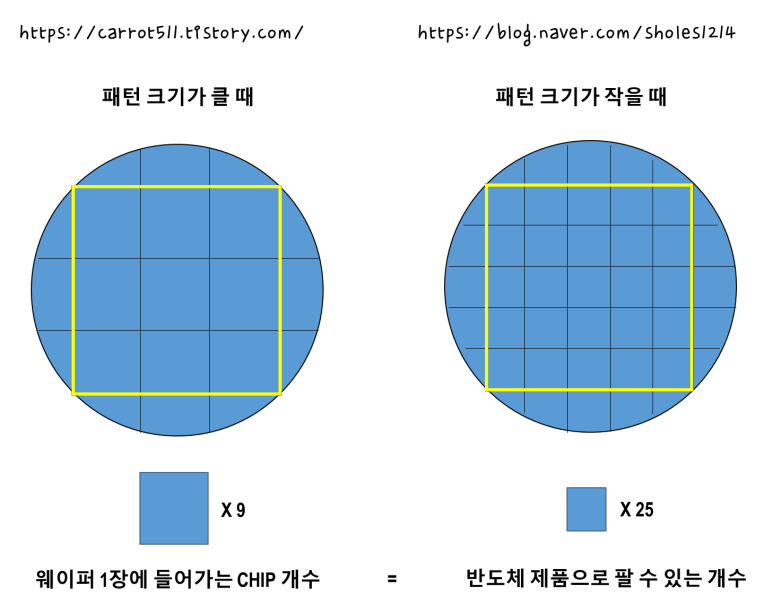
해상도와 단가 간 관계
광원 파장의 발전 순서
잘 암기해 봅시다. 직무면접에서 가끔 물어봐요.
광원 파장의 발전 순서
G-라인(436nm) → I-라인(365nm) → KrF(243nm) → ArF(193nm) → I-ArF(134nm)→ EUV(13.5nm)
최근까지는 UV(자외선) 영역의 파장이 사용되어 왔다.
KrF와 ArF는 Deep UV라고 한다. (= DUV)
※ 파장의 순서와 nm는 외워두는 게 좋다. 직무 면접에서 물어보기 때문에
짧은 파장의 광원을 만드는 원리는 다음과 같다.

어떤 원소에 에너지를 가하면, 전자가 들뜨게 된다 (Excited 상태라고 한다. 에너지를 받아서 신이 난 상태)
들뜬 전자는 전자껍질(n)을 뛰어올랐다가 다시 제자리로 내려오는데, 내려오면서 파장을 방출한다.
힘(에너지)을 많이 받을수록 높이 점프하여 올라가게 되고, 짧은 파장을 방출한다. (에너지와 파장은 반비례 관계!)
(전자껍질의 개념을 알려면 보어의 원자 모형을 이해해야 하는데, 이건 다시 설명하겠다.)

전자를 1번째 전자 띠로 이동시키면 자외선이 방출되고, 두 번째 전자띠로 이동시키면 가시광선, 세 번째로 이동시키면 적외선이 발생한다.
그리고 더욱 먼 외각 전자띠에서 첫 번째 전자띠로 떨어뜨리면 더욱 짧은 파장의 자외선이 발생하기 때문에, 점점 짧은 파장의 광원을 만들기 위해 높은 에너지가 필요하며 상대적으로 광의 에너지가 낮을 수 있다.
반도체 공정에서는 최근까지 높은 해상도 수준을 맞추기 위해 193nm인 ArF 광원을 오랫동안 사용했지만, 지금은 극 자외선이라는 EUV(Extrem UV) 광원을 사용하고 있다. EUV는 13.5nm 파장의 광원으로 기존 기술보다 10배 이상 짧은 파장의 광원을 말한다.
(ASML 독점 장비... 정말로 부르는 게 값이다. 근데 생각보다 장비가 엄청 잘 다운돼서 진짜 주옥같다. 개복치처럼 맨날 죽어버리는 장비...)

출처: ASML, 유튜브 주연
파장이 너무 짧으면 광의 에너지를 높이기 쉽지 않기 때문에, 초기에 광원 출력이 낮아서 생산성이 부족할 것이라는 문제점이 있었으나 거울 10개(특수 반사경)를 사용해서 에너지 손실을 최소화하고, 장비 내부를 진공으로 만들어 이런 문제점을 극복했다.
(파장이 너무 짧으며 공기나 CO2에 쉽게 흡수되고, 렌즈를 통과하면서도 에너지가 손실되기 때문)
이런 특성 때문에 EUV는 PR과 Mask(Reticle)의 재질이나 소재도 다르게 사용해야 한다.
(+) ASML 장비에 대한 이야기
예전 세대의 제품은 캐논, 니콘 회사들도 곧잘 만들어서 포토 장비의 점유율을 같이 채우고 있었다.
그런데 DUV 세대로 올라와서는 ASML을 전혀 따라오지 못하고 있는데 물론 EUV라는 높은 기술의 장벽도 있겠지만 DUV 장비에서도 밀리고 있다.
그 이유는 뭘까?

바로 이것 때문이다.
ASML 포토 장비는, 다른 회사의 제품들과 다르게 2 way 스캔 방식을 사용한다.
한쪽에서는 웨이퍼를 노광하기 전 준비하고 있고 (1)
다른 쪽에서는 준비된 웨이퍼를 노광한다 (2)
다른 장비들은 웨이퍼를 트랙에 넣고 노광 공정까지 진행한다면, ASML 장비는 웨이퍼 하나는 노광을 하고, 다른 하나까지 미리 노광 전 준비를 끝낸 상태.
이렇게 공정 시간을 단축하는 방식을 사용해서 (반도체 제품은 공정 시간과의 싸움...) 캐논과 니콘의 DUV 장비 점유율까지 빼앗아갔다.
이 영상에 스캔하는 방법이 잘 나오니까 참고해보자.
https://www.youtube.com/watch?v=wH7D8V47etk&t=15s&ab_channel=%EC%A3%BC%EC%97%B0ZUYONI
'반도체 > 전공면접' 카테고리의 다른 글
| 반도체 포토공정_ PR(포토레지스트) 성분, 원리, 종류(Positive, Negative PR), EUV PR의 특징 (0) | 2024.01.28 |
|---|---|
| 반도체 포토공정 DUV, i-ArF 원리 (immersion - ArF, 액침 노광 기법) (1) | 2024.01.28 |
| 포토 공정의 해상도(Resolution), 초점심도(DOF, Depth of Focus) (0) | 2024.01.28 |
| PHOTO공정 HMDS 처리를 하는 이유 (0) | 2024.01.28 |
| 반도체 단위공정 (3) Photo 포토 공정 순서(HDMS, PR, Soft Bake, Align, Exposure, PEB, Develop, Hard Bake) (0) | 2024.01.28 |